烧结型银纳米结合剂
通过独特的银纳米粒子设计和糊剂设计技术,它是一种烧结型银纳米粘合材料,可实现牢固的粘合强度,高导热性,可印刷性。
开发品概要
为了实现脱碳社会,功率半导体备受瞩目,作为代替传统焊接材料的新型接合材料,我们正在致力于烧结型银纳米接合材料的开发。
从对人体的有害性、环境负荷的观点出发,接合材料要求无铅。另外,功率半导体随着大电流化、高密度化而成为高温环境下的驱动,因此要求比以往更高的耐热性和散热性。
针对这些课题,本公司集团控制接合涂膜的致密性,开发出散热性优异的烧结型银纳米接合材料。
开发产品的特点
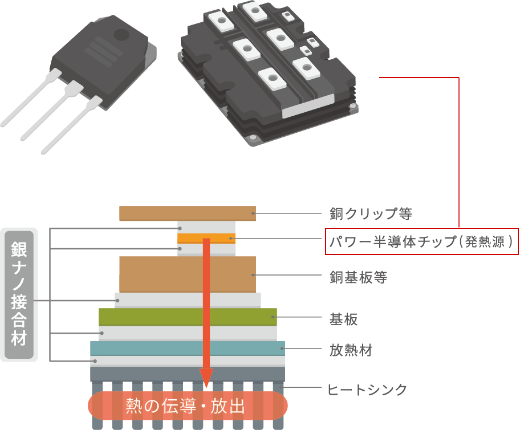
[下一代功率器件]
硅(工作温度:150-190℃)
⇒碳化硅(工作温度:200-300℃)
目前焊料的熔点为220℃,因此
耐热性不足。另一方面,烧结银
熔点约为960℃。
- 300W/m·k或更高,具有极高的导热性
- 通过无压烧结实现接合强度40MPa以上的牢固接合
(无需引入压力装置,可适用于不适合压力的材料,但也兼容压力烧结工艺。) - 卓越的金属蒙版和分页打印
开发品的特性
糊物性
| 开发品 | 焊料 (无铅) | |
|---|---|---|
| 银含量 | 87%以上 | ー |
| 粘度 | 20~100 Pa・s | ー |
接合条件
| 开发品 | 焊料 (无铅) | |
|---|---|---|
| 接合压力 | 非加压或加压 | 无加压 |
| 接合温度 | 230℃~300℃ | >320℃ |
| 烧结气氛 | Air,N2 | Air,N2 |
| 接合面 | Au, Ag, Cu | Au, Ag, Cu |
接合层特性
| 开发品 | 焊料 (无铅) | 测量方法 | |
|---|---|---|---|
| 接合强度 | >40MPa | 32MPa | 用分模仪测量 |
| 热循环 | >1000cyc | ー | -40°C30分钟↔ 150°C30分钟 |
| 高温耐热性 | >400℃ | 220°C (熔点) | ー |
| 电阻 | 3μΩ・cm | 13μΩ・cm | 双端子测量法 |
| 热传导率 | 300W/m・k | 65W/m・k | 激光闪光法 |
样品配置:5mm □芯片/接合层/基材
开发产品的特点

应用实例
对于需要高温操作的功率半导体、射频器件 (RF) 、发光二极管 (LED) 和半导体激光器 (LD) 中的芯片焊接、穿孔、子安装和封装焊接非常有用。
此外,它不仅适用于芯片和散热器的底部,还适用于形状复杂且难以加压的区域。



技术概述
独特的银纳米粒子设计技术和实现印刷性的浆料设计技术
在本次开发中,通过本公司的技术基础“独自的银纳米粒子设计技术”和“糊料设计技术 (分散技术和涂膜致密化技术) ”,表现出无加压烧结银的优良接合强度、高可靠性、高散热性等物理特性。
此外,它适用于金属蒙版和分配等印刷方法,并具有优异的粘度特性,可实现具有工艺优点的印刷性能,并将糊剂的废弃量降至最低。
独特的银纳米粒子设计技术
银纳米粒子是纳米尺寸的微粒子的银粒子。银的熔点为962°C,通过制成纳米粒子,熔点降低,实现了在200°C以上的温度下的烧结。这将实现诸如导热性和连接强度等特性。
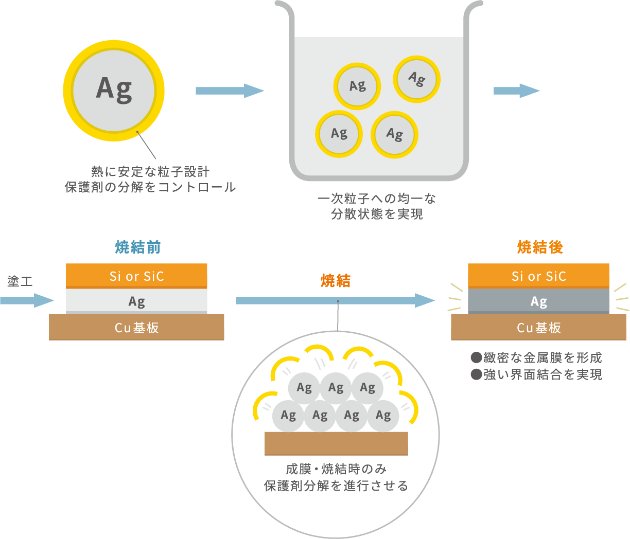
实现印刷性的糊料设计技术

粘度可根据印刷方式进行调整。
分页印刷方式
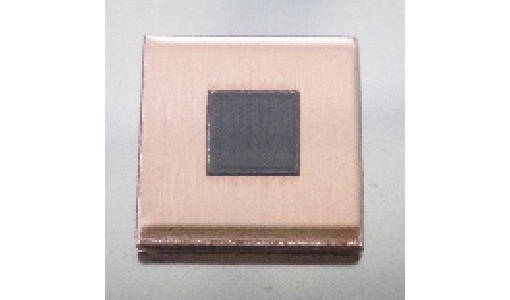
金属蒙版印刷示例

分配打印示例
联系我们
artience株式会社集团研发部门
TEL:+81-3-3272-5732
