焼結型銀ナノ接合材
独自の銀ナノ粒子設計とペースト設計技術により、強固な接合強度・高熱伝導性・印刷性を実現する焼結型銀ナノ接合材です。
開発品概要
脱炭素社会の実現に向けてパワー半導体が注目される中、従来のはんだ材料に代わる新たな接合材料として、焼結型銀ナノ接合材の開発に取り組んでいます。
接合材料は、人体への有害性・環境負荷の観点から、鉛フリーが求められています。また、パワー半導体は、大電流化・高密度化に伴い高温環境下での駆動となるため、これまで以上の耐熱性や放熱性が要求されます。
これら課題に対し、当社グループでは接合塗膜の緻密性を制御し、放熱性に優れた焼結型銀ナノ接合材を開発しています。
開発品の特長
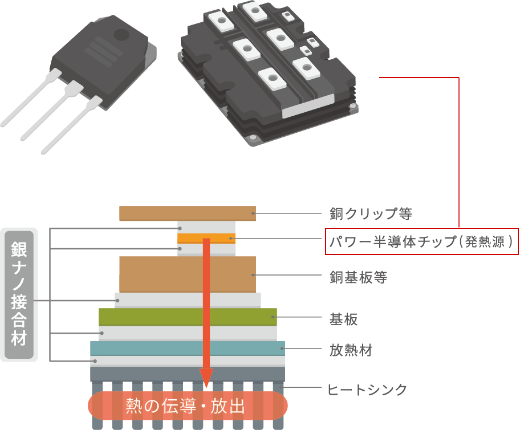
[ 次世代パワーデバイス ]
Si (動作温度:150~190℃)
⇒ SiC (動作温度:200~300℃)
現行のはんだは融点が220℃のため、
耐熱性が不足。一方、焼結銀は
約960℃の融点を持ちます。
- 300W/m・k以上の非常に高い高熱伝導性を実現
- 無加圧焼結において、接合強度40MPa以上の強固な接合を実現
(加圧装置の導入が不要。加圧に適さない材料への適用が可能です。ただし、加圧焼結プロセスにも対応しています。) - 優れたメタルマスク印刷、ディスペンス印刷を実現
開発品の特性
ペースト物性
| 開発品 | はんだ(鉛フリー) | |
|---|---|---|
| 銀含有量 | 87%以上 | ー |
| 粘度 | 20~100 Pa・s | ー |
接合条件
| 開発品 | はんだ(鉛フリー) | |
|---|---|---|
| 接合時圧力 | 無加圧または加圧 | 無加圧 |
| 接合温度 | 230℃~300℃ | >320℃ |
| 焼結雰囲気 | Air、N2 | Air、N2 |
| 接合面 | Au、Ag、Cu | Au、Ag、Cu |
接合層の特性
| 開発品 | はんだ(鉛フリー) | 測定方法 | |
|---|---|---|---|
| 接合強度 | >40MPa | 32MPa | ダイシェアメーターにて測定 |
| ヒートサイクル | >1000cyc | ー | -40℃30分↔150℃30分 |
| 高温耐熱性 | >400℃ | 220℃(融点) | ー |
| 電気抵抗 | 3μΩ・㎝ | 13μΩ・㎝ | 2端子測定法 |
| 熱伝導率 | 300W/m・k | 65W/m・k | レーザーフラッシュ法 |
サンプル構成:5mm□チップ /接合層/基材
開発品の特長

用途例
高温動作が求められるパワー半導体や高周波デバイス(RF)、発光ダイオード(LED)、半導体レーザ(LD)でのダイボンディング、ダイアタッチ、サブマウント、パッケージの接合に有用です。
また、チップ下やヒートシンクとの接合だけでなく、形状が複雑で加圧が難しい部位にもご使用いただけます。



技術概要
独自の銀ナノ粒子設計技術と印刷性を実現するペースト設計技術
本開発では、当社の技術基盤である「独自の銀ナノ粒子設計技術」と「ペースト設計技術(分散技術や塗膜の緻密化技術)」により、無加圧焼結銀の優れた接合強度や高い信頼性、高放熱性などの物理特性を発現します。
またメタルマスクやディスペンスなどの印刷方式に適合し、優れた粘度特性により、ペースト廃棄量を最小限にしたプロセスメリットのある印刷性を実現しています。
独自の銀ナノ粒子設計技術
銀ナノ粒子は、nmサイズの微粒子にした銀粒子です。銀の融点は962℃ですが、ナノ粒子にすることによって融点降下がおこり、200℃以上の温度における焼結を実現しました。これにより、熱伝導性や接合強度などの特性を実現します。
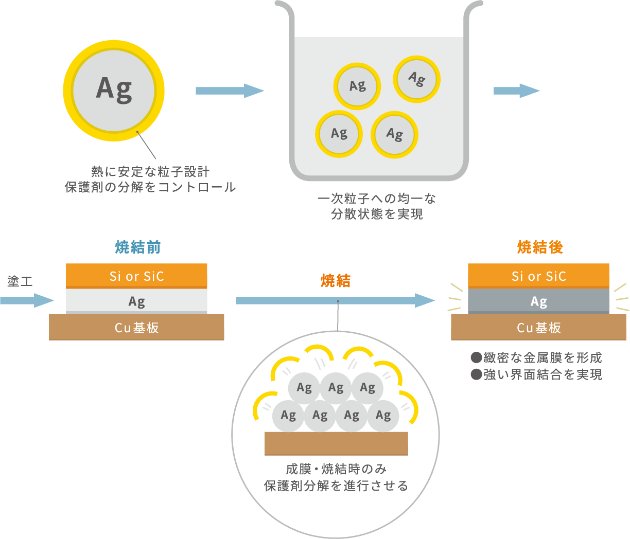
印刷性を実現するペースト設計技術

印刷方式に応じた粘度調整が可能です。
ディスペンス印刷方式
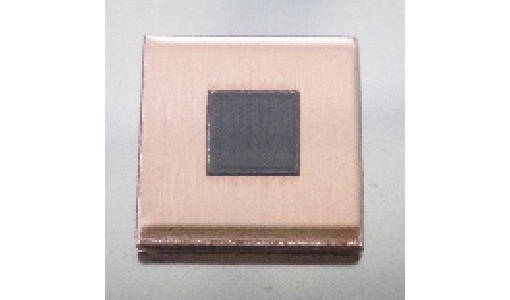
メタルマスク印刷例

ディスペンス印刷例
お問い合わせ
artience株式会社 グループ R&D 本部
TEL:03-3272-5732
